具有嵌入式内插器的微电子封装的制作方法-k8凯发
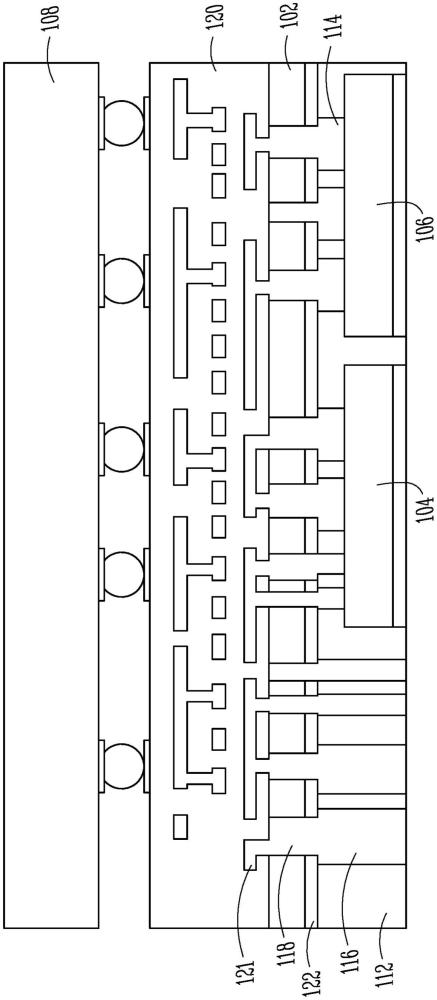
实施例涉及集成电路(ic)的封装。一些实施例涉及集成电路的ic封装互连。
背景技术:
1、电子系统经常包括作为子组件互连和封装的集成电路(ic)。希望将多种类型的ic管芯集成到单个封装中,从而在封装中建立有效率的系统。然而,随着封装电子系统因更多ic管芯的添加而变得更大,封装的面积外形因子(例如,x-y尺度)变得更大。如果封装的面积外形因子变得过大,那么封装可能易于发生翘曲。因而,存在对解决ic系统的互连和封装的尺寸挑战并且仍然提供鲁棒设计的装置、系统和方法的一般需求。
技术实现思路
技术特征:
1.一种电子装置,包括:
2.根据权利要求1所述的电子装置,其中,所述加强材料是玻璃,所述内插器层是玻璃内插器层,并且所述多个贯穿层过孔是包括金属的贯穿玻璃过孔(tgv)。
3.根据权利要求2所述的电子装置,包括布置在所述模制物层和所述玻璃内插器层之间的粘合层,并且所述tgv穿过所述粘合层延伸至所述模制物层的接触柱。
4.根据权利要求2所述的电子装置,其中,每个tgv包括位于所述tgv的两端上的焊料。
5.根据权利要求2所述的电子装置,其中,所述模制物层包括从所述模制物层的所述第一表面延伸至所述模制物层的相对的第二表面的至少一个额外接触柱,并且其中,所述玻璃内插器层包括接触所述至少一个额外接触柱的至少一个tgv。
6.根据权利要求2所述的电子装置,包括重新分布层,所述重新分布层接触所述玻璃内插器层并且包括与所述tgv电接触的至少一个导电互连层。
7.根据权利要求2所述的电子装置,其中,所述玻璃内插器层嵌入在接触所述模制物层并且包括与所述tgv电接触的至少一个导电互连层的重新分布层中。
8.根据权利要求1所述的电子装置,其中,所述加强材料是比所述封装基板更具刚性的金属,所述内插器层是金属内插器层,并且所述多个贯穿层过孔包括将所述金属内插器层的金属与所述贯穿层过孔的导电材料分隔开的绝缘电介质材料。
9.根据权利要求1-8中的任何一项所述的电子装置,其中,所述内插器层是玻璃内插器层并且所述玻璃内插器层使用焊料附接至所述模制物层。
10.一种形成电子系统的方法,所述方法包括:
11.根据权利要求10所述的方法,
12.根据权利要求11所述的方法,
13.根据权利要求11所述的方法,
14.根据权利要求11所述的方法,包括:
15.根据权利要求11所述的方法,包括:
16.根据权利要求11所述的方法,其中,将所述玻璃内插器层安装在所述模制物层上包括将所述玻璃内插器层嵌入在重新分布层中并且将所述重新分布层布置在所述模制物层上,其中,所述重新分布层包括与所嵌入的玻璃内插器层的至少一个tgv电接触的至少一个导电互连层。
17.根据权利要求10-16中的任何一项所述的方法,
18.一种封装电子系统,包括:
19.根据权利要求18所述的封装电子系统,其中,所述电子嵌入在布置于所述模制物层和所述玻璃内插器层之间的绝缘层中,并且所述绝缘层包括贯穿过孔,并且所述玻璃内插器层的所述tgv通过所述绝缘层的所述贯穿过孔与所述模制物层的所述导电柱电接触。
20.根据权利要求18所述的封装电子系统,包括重新分布层,所述重新分布层接触所述玻璃内插器层并且包括与所述tgv电接触的至少一个导电互连层。
21.根据权利要求18-20中的任何一项所述的封装电子系统,其中,所述电子装置是位于所述至少两个ic管芯之间的管芯到管芯桥连接器。
技术总结
一种电子装置包括:设置在具有基板区域的封装基板上的多个集成电路(ic)管芯;模制物层,其包括所述ic管芯和从至少一个ic管芯的表面延伸至所述模制物层的第一表面的多个导电柱;以及在所述基板区域之上延伸并且包括比所述封装基板的材料更具刚性的加强材料的内插器层。所述内插器层包括在模制物层的第一表面处接触导电柱并且穿过加强材料延伸至内插器层的第二表面的多个导电贯穿层过孔。
技术研发人员:r·n·马内帕利,h·阿齐米
受保护的技术使用者:英特尔公司
技术研发日:
技术公布日:2024/2/8
- 还没有人留言评论。精彩留言会获得点赞!